樹脂塞孔是一種在電路板制造過程中,利用樹脂材料填充通孔(Through Hole)或盲孔(Blind Via)的工藝。
普林電路可制作的樹脂塞孔類型
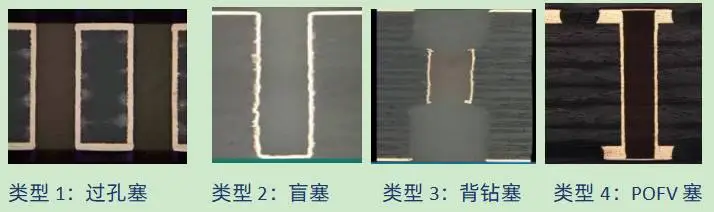
樹脂材料填充孔洞后,能夠有效增強電路板的結構強度,減少因熱膨脹或機械應力導致的孔壁開裂或分層問題。特別是在HDI板中,樹脂塞孔可以防止多層板在熱壓合過程中出現孔壁變形或斷裂,從而提高電路板的整體可靠性。
2、防止焊料流入孔內導致短路在焊接過程中,焊料可能會流入未填充的孔內,導致短路或虛焊等問題。樹脂塞孔通過填充孔洞,阻隔了焊料的流動,確保焊接過程的穩定性和可靠性,尤其在高精度、高密度的電路板中尤為重要。
3、提供平整表面便于后續加工樹脂塞孔后,孔洞被完全填充并經過研磨處理,使電路板表面更加平整。這種平整的表面為后續的層壓、鍍銅、阻焊層涂覆等工藝提供了更好的基礎,確保電路板的層間結合力和表面質量。
4、提升電氣性能和信號完整性樹脂材料具有良好的絕緣性能,能夠有效減少信號傳輸過程中的電磁干擾(EMI)和串擾。同時,樹脂塞孔可以減少孔內的空氣間隙,降低信號反射和損耗,從而提高電路板的電氣性能和信號完整性。
樹脂塞孔的工藝流程在樹脂填充之前,必須對孔壁進行徹底清潔,去除油污、氧化物和灰塵等污染物。常用的清潔方法包括化學清洗、等離子清洗和超聲波清洗。清潔后的孔壁應具有良好的潤濕性,以確保樹脂能夠充分填充孔洞。

樹脂填充是樹脂塞孔工藝的核心步驟。常用真空壓力的填充方法:在真空環境下,利用壓力將樹脂壓入孔內,確保孔洞完全填充且無氣泡。

填充完成后,樹脂需要通過加熱或紫外線照射進行固化。固化過程中需要嚴格控制溫度和時間,以確保樹脂完全固化并達到所需的機械性能和電氣性能。固化后的樹脂應具有良好的附著力,避免出現分層或開裂。
04固化后,電路板表面會殘留多余的樹脂,需要通過研磨處理將其去除。研磨工藝需要精確控制研磨深度,避免損傷電路板的銅層或其他結構。研磨后的表面應平整光滑,為后續工藝提供良好的基礎。
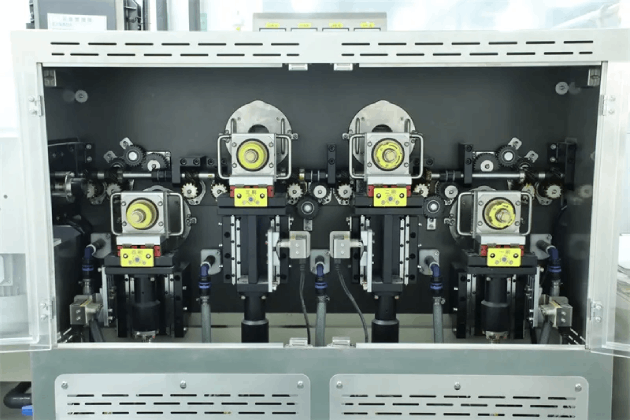

在高真空環境下進行塞孔作業,有效解決孔內和孔口氣泡問題,確保樹脂填充均勻無缺陷。
特別適合高厚徑比(1:40通孔、1:1盲孔)的塞孔需求,突破傳統工藝的限制。
02采用獨特的“兩塞一刮”工藝,確保樹脂充分填充孔洞,同時避免樹脂溢出或表面不平整。
適用于多種孔類型,包括激光盲孔、控深孔、通孔和背鉆孔。
03塞孔速度可在1150mm/s之間靈活調節,適應不同工藝需求,產能高達60120pnl/H。
支持最大板尺寸620762mm,最小板尺寸200200mm,板厚范圍0.18.0mm,滿足多樣化生產需求。
04樹脂塞孔直徑范圍0.152.0mm,適用于高密度互連板、多層板和厚板制造。
支持完成銅厚1oz和2oz的電路板,最小線寬分別為3.5/3.5和5/5(局部線到pad)。
設備優勢解決高難度塞孔問題:高真空環境和兩塞一刮工藝,有效解決氣泡、高厚徑比塞孔難題。
提升生產效率:高速塞孔和自動化操作,大幅提高產能,適合大規模生產。
保證產品質量:高精度填充和均勻固化,確保電路板的機械強度和電氣性能。
靈活適應多種需求:支持多種孔類型、板厚和尺寸,滿足不同客戶的生產要求。
應用場景HDI板:解決微小孔洞(0.15mm以上)的填充難題,提升電路板可靠性。
多層板和厚板:適用于高厚徑比孔洞的填充,避免分層和變形問題。
背鉆孔板:精準填充背鉆孔,確保信號完整性和電氣性能。
深圳普林電路的樹脂塞孔機以其高真空技術、兩塞一刮工藝和高效生產能力,成為解決高難度塞孔問題的理想選擇。無論是HDI PCB、多層板還是高厚徑板,深圳普林電路都能提供高效、精準的樹脂塞孔解決方案,助力客戶提升產品質量和生產效率。
2025-05-09
2025-05-09
2025-05-09
2025-05-09
2025-05-09
2025-05-08
相關新聞